后摩尔定律时代,芯片制程很难从7nm 缩小到更高制程,先进封装是提高封装效率的新途径,通过以点带线方式实现电气互联,实现更高密度集成。SiP及PoP奠定了先进封装时代的开局。
WaferLevelPackaging(WLP,晶圆级封装)、Flip-Chip(倒晶)、3D封装,ThroughSiliconVia(硅通孔,TSV)等出现进一步缩小芯片间连接距离,提高元器件的反应速度。下图是封装主流发展趋势:
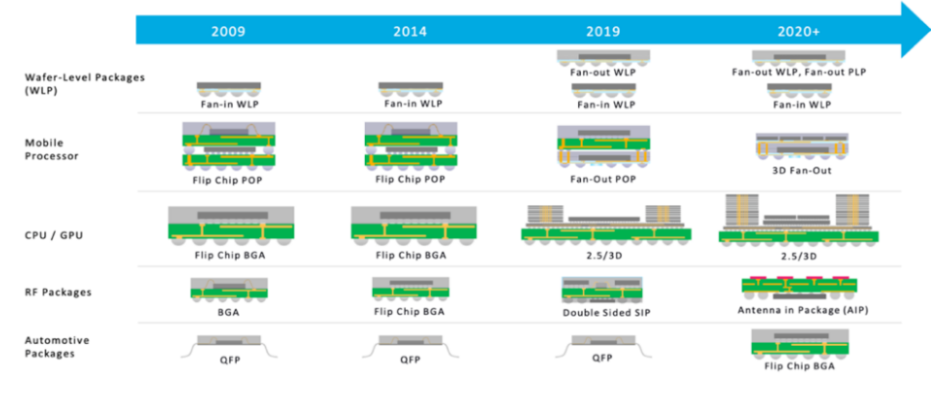
更先进的封装技术,意味着更高的工艺和复杂度,也意味着需要更高的质量控制和检测。以Bump为例,Bump高度从200um降到5um,一个die超过 25,000 个 bumps。未来会提升到50-60,000 个bumps。在整个先进封装中,Wafer-Level Packaging 缺陷检测,Die的缺陷检测和分拣,IC芯片的缺陷检测和分拣都需要光学元器件有着更高的速度和精度响应。
博视像元 Bopixel 作为半导体领域高端核心视觉成像部件供应商,于2023年3月正式推出了应用于半导体先进封装和封测领域缺陷检测的主动成像光学利器— OPR407系列DLP光机。

主要特性
1.50mm标准视野,4-200mm 视野可调,覆盖bump 到BGA主流尺寸;
2.4mm 视野下x轴 2um横向分辨率 ,兼容最小Bump直径;
3.蓝光模式下,0.05%畸变率,确保大视野下重复精度;
4.无风扇设计、全金属结构、无机械振动和电磁干扰;
5.沙姆和正投系列,满足半导体和PCBA行业多光机单相机或单光机多相机成像模式;
6.超高速,在12mm 视野下,实现1小时扫描22片300mm(13英寸)晶圆速度;
7.快速简单可编程主动成像光栅,同时兼容高精度和高景深应用场景;
8.多光机串联触发,实现360度无死角成像;
9.紧凑设计、行业最小尺寸;

全新的OPR407 系列DLP光机,配合博视像元Bopixel 具有6500万像素的Fanless高速超大分辨率相机BC-GM65M12X4H 、2500万像素的Fanless 超高速相机BC-GM2512X4组成的多光机多相机系统,可以实现Wafer-Level Packaging 、Die的缺陷检测和分拣、IC芯片的缺陷检测和分拣,在12mm X 12mm 视野下,可实现Z轴50nm的超高分辨率缺陷检测能力。
博视像元BOPIXEL 设有中国和日本两大研发中心,拥有40余人的国际顶级研发团队。立足中国放眼全球,依托于高端核心影像部件,以解决“卡脖子”和国产替代为契机,专注于半导体、新能源、消费电子等领域市场开拓,目前已经和世界500强企业、20余家全球热门行业头部客户形成正式销售订单;与半导体、新能源领域的3家世界级头部企业达成独家定制或深度战略合作;产品打入半导体前道、半导体封测、锂电、光伏、消费电子等高端领域;成功开拓中国大陆、日本、韩国、法国、中国台湾、东南亚等市场。